TSMC为新一代Copos包装技术做准备:到2028年底,
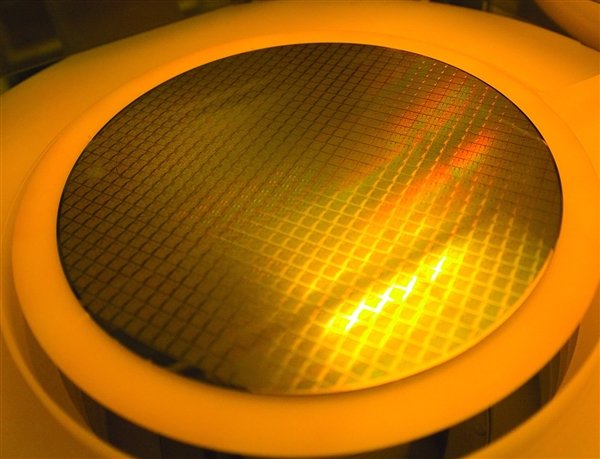 据媒体报道,TSMC正在积极准备新一代Copos(木板木板)包装技术,该技术可以显着将包装基板大小的大小扩大到310 x 310mm甚至更大。 COPO的主要变化在于插入器的“围墙”,这是现有的Cowos-L和Cowos-R(基于平方基板)的另一种演变。它的本质是用大型矩形面板基板作为载体代替传统的圆形晶圆。根据该计划,TSMC将在2026年建立COPOS飞行员生产线,重点介绍2027年优化该过程以满足合作伙伴需求的过程,并旨在从2028年底到2029年初实现Copos群众生产。 FOPLP是一种包装方法,不需要INTErposer层,将芯片直接重新分布到面板基板上,并与重新分布层(RDL)坐标。该方法具有低成本,高I/O密度和柔性外观的好处。它适用于Edge AI,移动设备和中端ASIC等应用程序中等集成密度的应用。 COPOS引入了一个插入式层,具有较高的信号完整性和稳定的功率传输,这对于包括GPU和HBM芯片在内的高端产品更好。同时,插入器材料从传统的硅变为眼镜,这将提供更高的成本效益和热量的智力。预计Copos将来将取代Cowos-L,而Nvidia可能会成为第一个合作伙伴。 [本文的结尾]如果您需要打印,请确保指示来源:Kuai技术编辑:Lujiao
据媒体报道,TSMC正在积极准备新一代Copos(木板木板)包装技术,该技术可以显着将包装基板大小的大小扩大到310 x 310mm甚至更大。 COPO的主要变化在于插入器的“围墙”,这是现有的Cowos-L和Cowos-R(基于平方基板)的另一种演变。它的本质是用大型矩形面板基板作为载体代替传统的圆形晶圆。根据该计划,TSMC将在2026年建立COPOS飞行员生产线,重点介绍2027年优化该过程以满足合作伙伴需求的过程,并旨在从2028年底到2029年初实现Copos群众生产。 FOPLP是一种包装方法,不需要INTErposer层,将芯片直接重新分布到面板基板上,并与重新分布层(RDL)坐标。该方法具有低成本,高I/O密度和柔性外观的好处。它适用于Edge AI,移动设备和中端ASIC等应用程序中等集成密度的应用。 COPOS引入了一个插入式层,具有较高的信号完整性和稳定的功率传输,这对于包括GPU和HBM芯片在内的高端产品更好。同时,插入器材料从传统的硅变为眼镜,这将提供更高的成本效益和热量的智力。预计Copos将来将取代Cowos-L,而Nvidia可能会成为第一个合作伙伴。 [本文的结尾]如果您需要打印,请确保指示来源:Kuai技术编辑:Lujiao 上一篇:第一款新的宝马一代车型宝马IX3正在上路,并将
下一篇:没有了
下一篇:没有了





